在当今快速发展的电子行业中——由人工智能(AI)、高性能计算(HPC)及先进通信系统驱动——热管理已成为提升性能与确保可靠性的关键因素。而导热扩散正是其中至关重要的核心技术。
导热界面材料(TIM)的关键作用
实现高效导热扩散的核心,是导热界面材料(TIM, Thermal Interface Materials)——尤其是TIM1、TIM2以及日益重要的TIM1.5。掌握它们的性能和应用场景,对从事半导体封装与系统级设计的工程师至关重要。
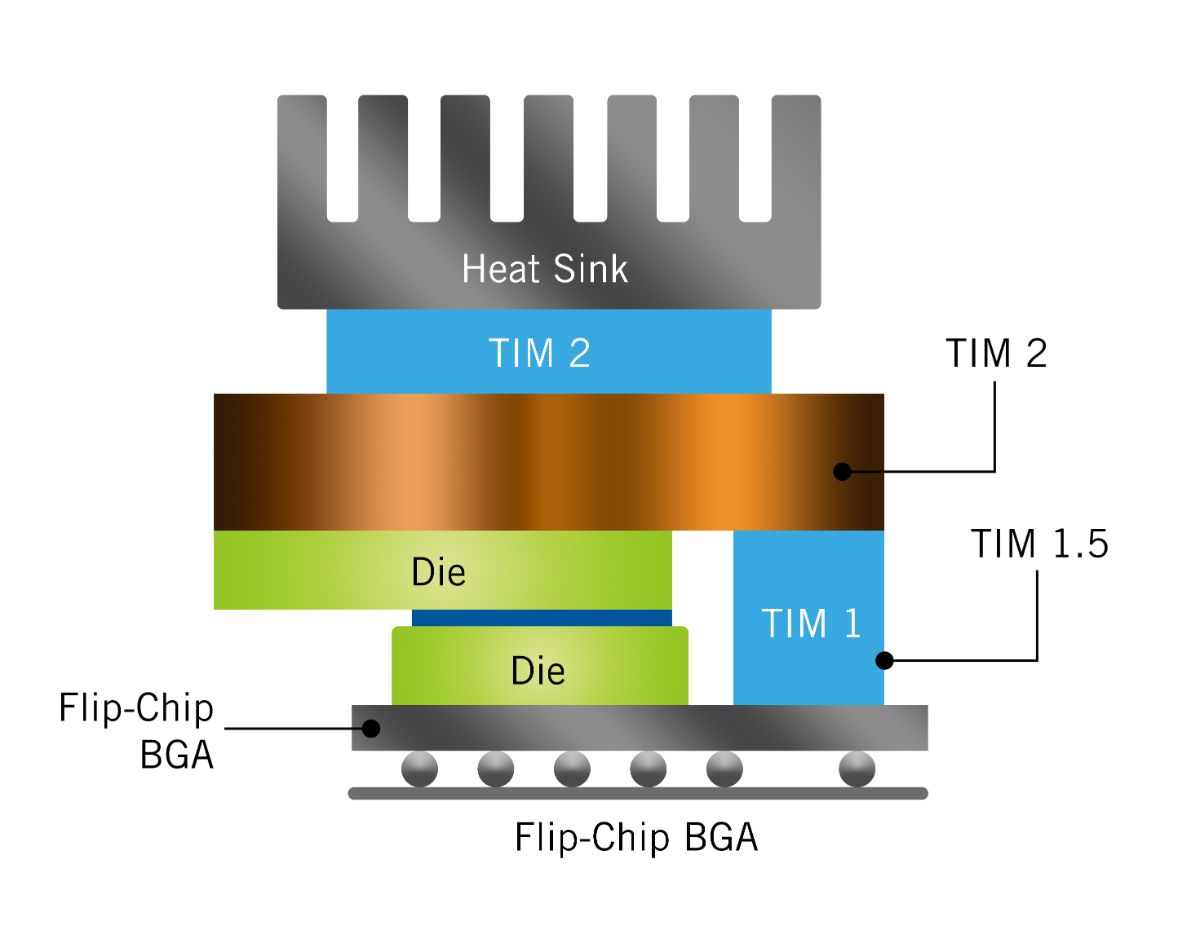
什么是 TIM1、TIM2 和 TIM1.5?
| TIM类型 | TIM1 | TIM2 | TIM3 |
|---|---|---|---|
| 应用位置 | 位于半导体芯片(如CPU、GPU)与集成热扩散盖板(IHS)之间,用于快速传导芯片产生的高热流密度。 |
连接IHS与外部散热器(如风冷、均热板、液冷板),用于将热量进一步传导至整体散热系统。 |
用于无盖封装(lidless package),让裸芯片直接与散热器接触,越来越多应用于AI服务器和高性能计算,满足极高的散热与应力释放需求。 |
| 常用材料 | 硅基导热胶、铟预成型片、银胶、石墨烯 | 高性能导热膏、导热垫、间隙填充胶、石墨烯 | 高性能导热膏、相变材料、液态金属、石墨烯 |
关键性能与应用差异
| TIM类型 | TIM 1 | TIM 2 | TIM 1.5 |
|---|---|---|---|
| 导热系数与扩散效率 | 需具备极高导热率(4–80 W/m·K,以应对芯片端极高热流密度。 | 导热率通常为2–7 W/m·K,适用于已扩散热流的传导。 | 兼顾高导热(8–20 W/m·K)与机械保护,尤其适用于AI及HPC。 |
| 机械稳定性与界面接触 | 要求优异的表面贴合性,减少芯片与IHS间微小空隙。 | 需在长时间及温度循环中保持稳定性能。 | 需保护易损的裸芯片,同时维持高效散热与可靠性。 |
为什么TIM选择对半导体封装至关重要?
在半导体封装中,TIM选择并非“一刀切”。需要综合考虑:
- 芯片功率密度与热流分布
- 封装结构与尺寸设计
- 系统散热方案(风冷、液冷等)
- 回流焊及长期热应力下的可靠性
随着AI驱动的无盖封装日益普及,TIM1.5的重要性显著提升。
Heraeus贺利氏电子:引领AI与HPC热管理新材料
Heraeus Electronics推出的新一代TIM1解决方案,导热率超过30 W/m·K,具备:
- 无需芯片或盖板背镀金属层
- 多次回流后仍能保持低空洞率与高稳定性
- 特别适用于AI服务器及高性能计算中极端热负载环境
同时,我们正不断扩展TIM1.5产品组合,助力AI数据中心与无盖封装实现高效可靠的热管理。
立即优化您的热设计!
无论是高性能导热材料还是定制化热管理方案,Heraeus Electronics助您在半导体封装创新中保持领先。
联系我们,探索适合您下一代设计的最佳导热解决方案。
SingaporeHeraeus Materials Singapore Pte.Ltd
Heraeus Electronics Locations
发送邮件Heraeus Electronics SingaporeNo. 26 Pioneer CrescentSingapore 628558新加坡

